
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Що таке процеси LPCVD?
Процеси хімічного осадження з парової фази під низьким тиском (LPCVD) — це методи CVD, які осаджують тонкоплівкові матеріали на поверхні пластин під низьким тиском. Процеси LPCVD широко використовуються в технологіях осадження матеріалів для виробництва напівпровідників, оптоелектроніки та тонкоплівкових сонячних елементів.
Реакційні процеси LPCVD зазвичай проводяться в реакційній камері низького тиску, як правило, при тиску 1–10 торр. Після нагрівання пластини до температурного діапазону, придатного для реакції осадження, газоподібні прекурсори вводяться в реакційну камеру для осадження. Реактивні гази дифундують до поверхні пластини, а потім піддаються хімічним реакціям на поверхні пластини в умовах високої температури з утворенням твердих відкладень (тонких плівок).
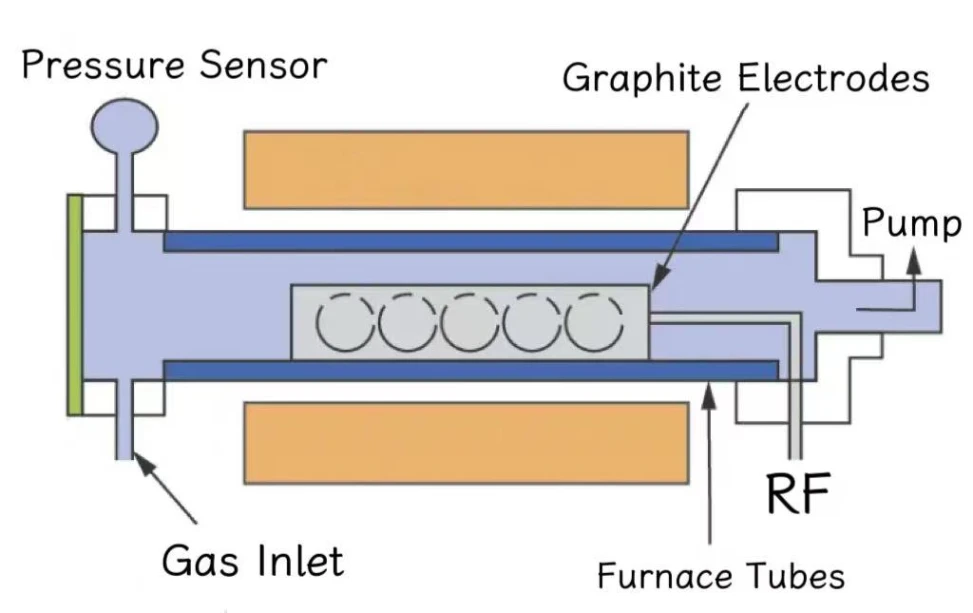
Переваги процесів LPCVD
1. Високоякісна якість осадження тонкої плівки
Швидкість транспортування газів-реагентів прискорюється, коли тиск низький, оскільки збільшується коефіцієнт дифузії газів. Таким чином можна створити більш рівномірний розподіл молекул газу по всій реакційній камері, що забезпечує повну реакцію молекул газу з поверхнею пластини та значно зменшує порожнечі або різницю в товщині, викликану незавершеними реакціями.
2. Чудове покриття кроків плівки
Посилена газодифузійна здатність під низьким тиском дозволяє йому глибоко проникати в складні структури. Це забезпечує повний контакт реактивного газу зі східцями та канавками на поверхні пластини, що забезпечує рівномірне осадження тонких плівок. Як наслідок, осадження тонкої плівки на складних структурах є хорошим застосуванням для методу LPCVD.
3. Сильна операційна керованість
Процеси LPCVD демонструють сильну керованість під час фактичної роботи. Склад, структуру та товщину тонкої плівки можна точно контролювати, регулюючи параметри газу-реагенту, такі як тип, швидкість потоку, температура та тиск. Обладнання LPCVD має відносно низькі інвестиційні та експлуатаційні витрати порівняно з іншими технологіями осадження, що робить його придатним для великомасштабного промислового виробництва. А узгодженість процесів під час масового виробництва може бути ефективно забезпечена автоматизованими системами, які контролюють і коригують у режимі реального часу.
Недоліки процесів LPCVD
Оскільки процеси LPCVD зазвичай виконуються при високих температурах, що обмежує застосування деяких чутливих до температури матеріалів, пластини, які потрібно обробляти LPCVD, повинні бути термостійкими. Під час процесів LPCVD можуть виникнути небажані проблеми, такі як осадження пластини (тонкі плівки, нанесені на нецільові ділянки пластини) і труднощі з легуванням на місці, для вирішення яких потрібна подальша обробка. Крім того, низька концентрація пароподібних прекурсорів в умовах низького тиску може призвести до нижчої швидкості осадження тонкої плівки, що призводить до неефективної ефективності виробництва.
Semicorex пропонує високу якістьSiC фурна трубкаs, SiC консольні веслаіВафельні човники SiCдля процесів LPCVD. Якщо у вас є запитання або вам потрібна додаткова інформація, будь ласка, не соромтеся зв’язатися з нами.
Контактний телефон +86-13567891907
Електронна адреса: sales@semicorex.com





