
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Дислокація в кристалах SiC
Підкладка SiC може мати мікроскопічні дефекти, такі як зміщення різьбового гвинта (TSD), зміщення краю різьблення (TED), зміщення базової площини (BPD) та інші. Ці дефекти викликані відхиленнями в розташуванні атомів на атомному рівні.
SiC crystals typically grow in a way that extends parallel to the c-axis or at a small angle with it, which means that the c-plane is also known as the base plane. There are two main types of dislocations in the crystal. When the dislocation line is perpendicular to the base plane, the crystal inherits dislocations from the seed crystal into the epitaxial grown crystal. These dislocations are known as penetrating dislocations and can be categorized into threading edge dislocations(TED) and threading screw dislocations(TSD) based on the orientation of the Bernoulli vector to the dislocation line. Dislocations, where both the dislocation lines and the Brönsted vectors are in the base plane, are called base plane dislocations(BPD). SiC crystals can also have composite dislocations, which are a combination of the above dislocations.
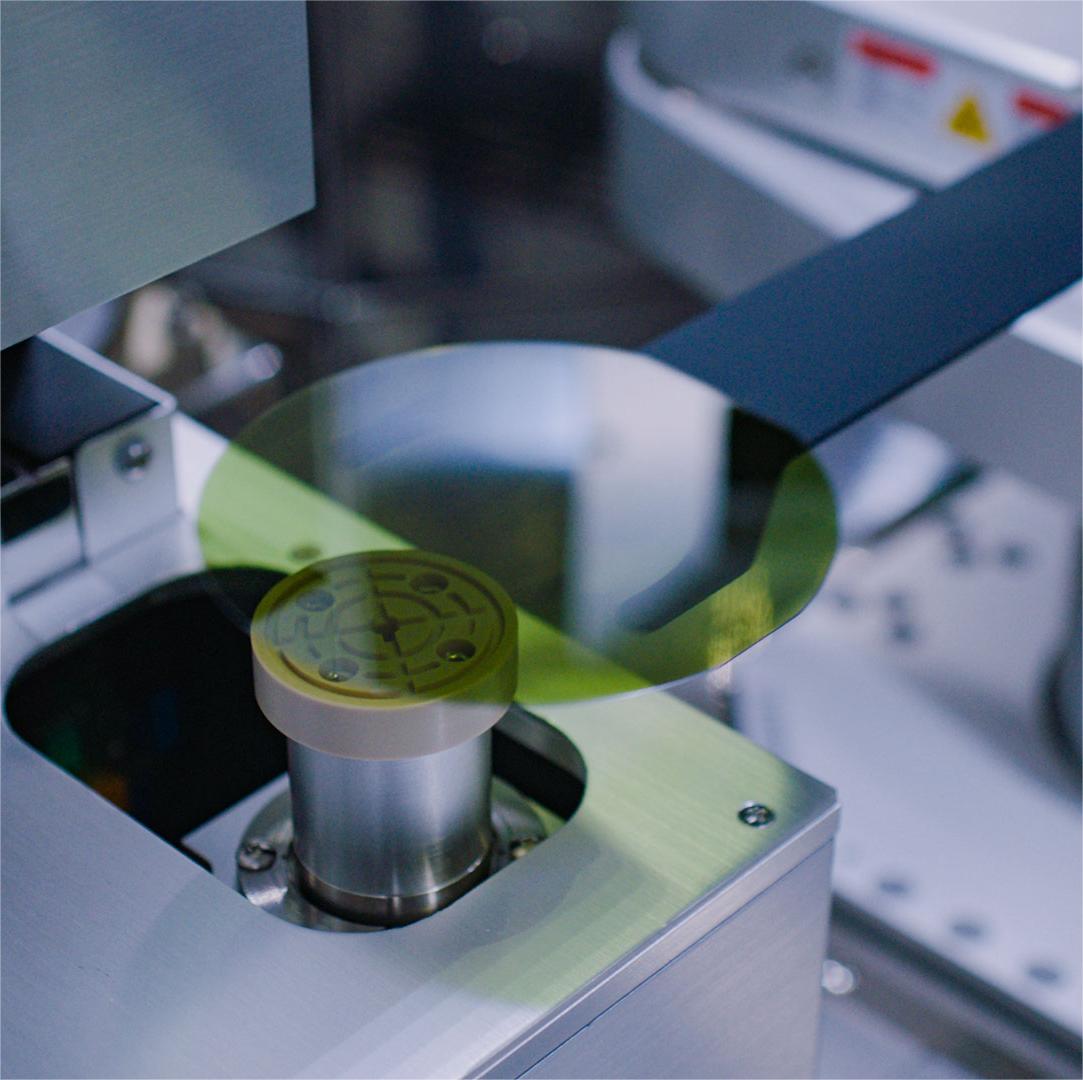
1. TED&TSD
І різьбові дислокації (TSD), і різьбові крайові дислокації (TED) проходять уздовж осі росту [0001] з різними векторами Бюргерса <0001> і 1/3<11-20> відповідно.
Як TSD, так і TED можуть простягатися від підкладки до поверхні пластини та створювати невеликі ямкові деталі поверхні. Як правило, щільність TED становить приблизно 8000-10 000 1/см2, що майже в 10 разів перевищує щільність TSD.
Під час процесу епітаксіального росту SiC TSD поширюється від підкладки до епітаксійного шару розширеного TSD може трансформуватися в інші дефекти на площині підкладки та поширюватися вздовж осі росту.
Було показано, що під час епітаксійного росту SiC TSD трансформується в дефекти шару укладання (SF) або дефекти моркви на площині підкладки, тоді як показано, що TED в епітаксіальному шарі трансформується з BPD, успадкованого від підкладки під час епітаксійного росту.
2. БЛД
Базально-площинні дислокації (BPD), які розташовані в площині [0001] кристалів SiC, мають вектор Бюргерса 1/3 <11-20>.
BPD рідко з’являються на поверхні пластин SiC. Зазвичай вони концентруються на підкладці з густиною 1500 л/см2, тоді як їх густина в епітаксіальному шарі становить лише близько 10 л/см2.
Зрозуміло, що щільність BPD зменшується зі збільшенням товщини підкладки SiC. При дослідженні за допомогою фотолюмінесценції (PL) BPD показують лінійні особливості. Під час процесу епітаксійного росту SiC розширений BPD може бути перетворений у SF або TED.
З вищесказаного очевидно, що дефекти присутні в пластині підкладки SiC. Ці дефекти можуть бути успадковані під час епітаксійного росту тонких плівок, що може призвести до фатального пошкодження пристрою SiC. Це може призвести до втрати таких переваг SiC, як сильне поле пробою, висока зворотна напруга та низький струм витоку. Крім того, це може знизити рівень кваліфікації продукту та створити величезні перешкоди для індустріалізації SiC через зниження надійності.




