
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe у виробництві мікросхем: професійний новинний звіт
Еволюція напівпровідникових матеріалів
У сфері сучасних напівпровідникових технологій невпинне прагнення до мініатюризації розсунуло межі традиційних матеріалів на основі кремнію. Щоб задовольнити вимоги щодо високої продуктивності та низького енергоспоживання, SiGe (кремнієвий германій) став композиційним матеріалом вибору у виробництві напівпровідникових мікросхем завдяки своїм унікальним фізичним та електричним властивостям. У цій статті йдеться пропроцес епітаксіїSiGe та його роль в епітаксіальному зростанні, застосуванні напруженого кремнію та структурах Gate-All-Around (GAA).
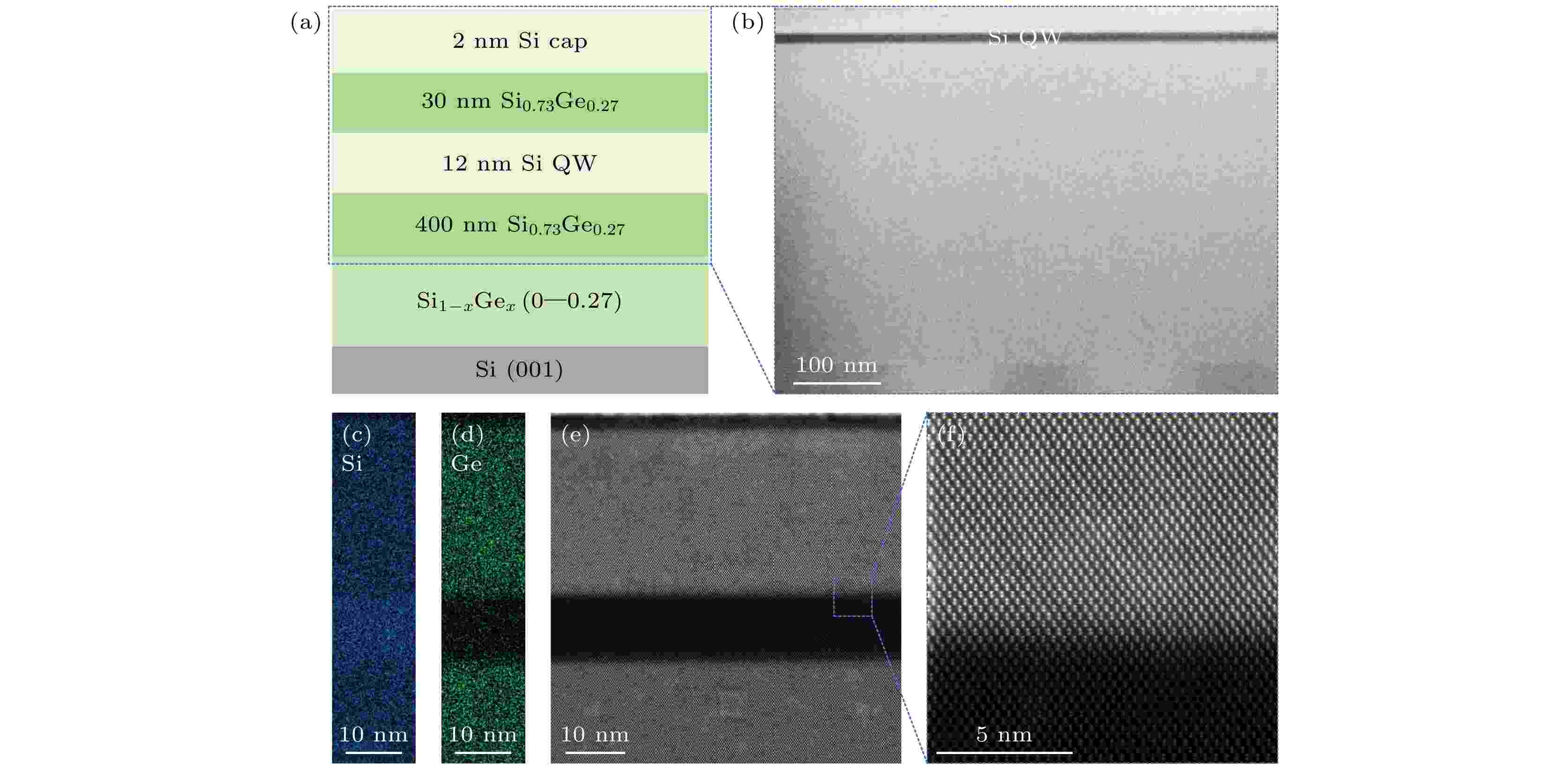
Значення SiGe епітаксії
1.1 Вступ до епітаксії у виробництві мікросхем:
Епітаксія, часто скорочена як Epi, відноситься до росту монокристалічного шару на монокристалічній підкладці з таким самим розташуванням решітки. Цей шар може бути будь-якимгомоепітаксіальний (наприклад, Si/Si)або гетероепітаксіальні (такі як SiGe/Si або SiC/Si). Для епітаксійного вирощування використовуються різні методи, зокрема молекулярно-променева епітаксія (MBE), хімічне осадження з парової фази в ультрависокому вакуумі (UHV/CVD), епітаксія за атмосфери та зниженого тиску (ATM & RP Epi). Ця стаття присвячена процесам епітаксії кремнію (Si) і кремнію-германію (SiGe), які широко використовуються у виробництві напівпровідникових інтегральних схем із кремнієм як матеріалом підкладки.
1.2 Переваги SiGe епітаксії:
Включаючи певну частку германію (Ge) під часпроцес епітаксіїутворює монокристалічний шар SiGe, який не тільки зменшує ширину забороненої зони, але також збільшує частоту зрізу транзистора (fT). Це робить його широко застосовним у високочастотних пристроях для бездротового та оптичного зв’язку. Крім того, у вдосконалених процесах інтегральних схем CMOS невідповідність ґрат (приблизно 4%) між Ge і Si створює напругу ґратки, підвищуючи рухливість електронів або дірок і таким чином збільшуючи струм насичення пристрою та швидкість відгуку.
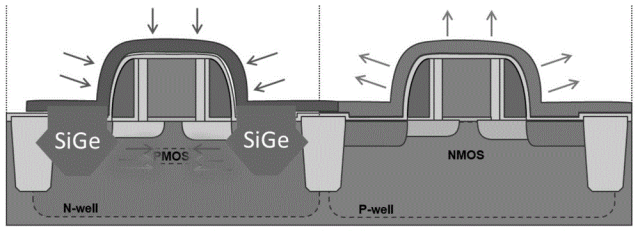
Комплексний процес епітаксії SiGe
2.1 Попередня обробка:
Кремнієві пластини проходять попередню обробку на основі бажаних результатів процесу, головним чином передбачаючи видалення природного оксидного шару та домішок з поверхні пластини. Для пластин із сильно легованою підкладкою вкрай важливо розглянути, чи необхідне зворотне запечатування для зменшення автоматичного легування під час наступнихепітаксія зростання.
2.2 Ростові гази та умови:
Кремнієві гази: силан (SiH₄), дихлорсилан (DCS, SiH₂Cl₂) і трихлорсилан (TCS, SiHCl₃) є трьома найпоширенішими джерелами газу кремнію. SiH₄ підходить для процесів повної епітаксії при низькій температурі, тоді як TCS, відомий своєю швидкою швидкістю росту, широко використовується для приготування товстихкремнієва епітаксіяшари.
Газоподібний германій: германій (GeH₄) є основним джерелом для додавання германію, який використовується разом із джерелами кремнію для формування сплавів SiGe.
Вибіркова епітаксія: вибіркове зростання досягається шляхом регулювання відносних показниківепітаксіальне осадженняі травлення на місці з використанням хлорвмісного газу кремнію DCS. Селективність пояснюється меншою адсорбцією атомів Cl на поверхні кремнію, ніж на оксидах або нітридах, що сприяє епітаксійному росту. SiH₄, без атомів Cl і з низькою енергією активації, як правило, застосовується лише для низькотемпературних процесів повної епітаксії. Інше часто використовуване джерело кремнію, TCS, має низький тиск пари та є рідким при кімнатній температурі, тому для введення його в реакційну камеру потрібне барботування H₂. Однак він відносно недорогий і часто використовується через його швидку швидкість росту (до 5 мкм/хв) для вирощування більш товстих кремнієвих епітаксійних шарів, які широко застосовуються у виробництві кремнієвих епітаксійних пластин.
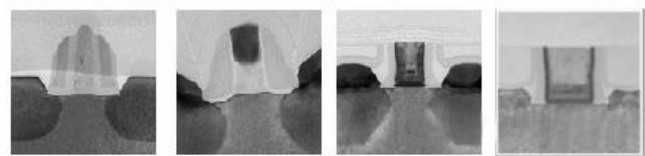
Напружений кремній в епітаксіальних шарах
Протягомепітаксіальний ріст, епітаксіальний монокристал Si наноситься на розслаблений шар SiGe. Через невідповідність граток між Si та SiGe монокристалічний шар Si піддається розтягуванню від нижнього шару SiGe, що значно підвищує рухливість електронів у транзисторах NMOS. Ця технологія не тільки збільшує струм насичення (Idsat), але й покращує швидкість реакції пристрою. Для пристроїв PMOS шари SiGe епітаксіально вирощуються в областях витоку та стоку після травлення, щоб створити напругу стиснення в каналі, підвищуючи рухливість отворів і збільшуючи струм насичення.
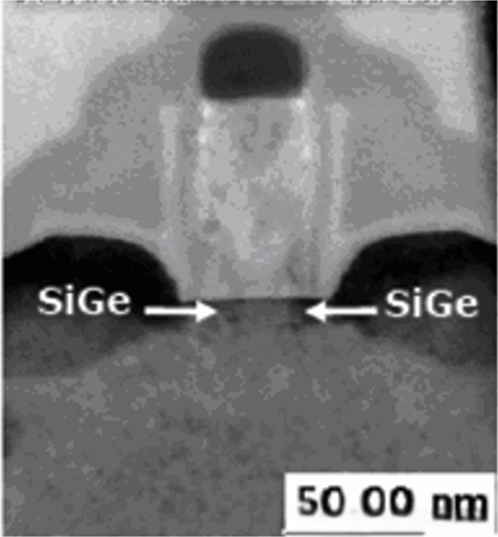
SiGe як жертовний шар у структурах GAA
У виробництві нанодротяних транзисторів Gate-All-Around (GAA) шари SiGe діють як жертвуючі шари. Високоселективні методи анізотропного травлення, такі як травлення квазіатомного шару (квазі-ALE), дозволяють точно видаляти шари SiGe для формування нанодротяних або нанолистових структур.
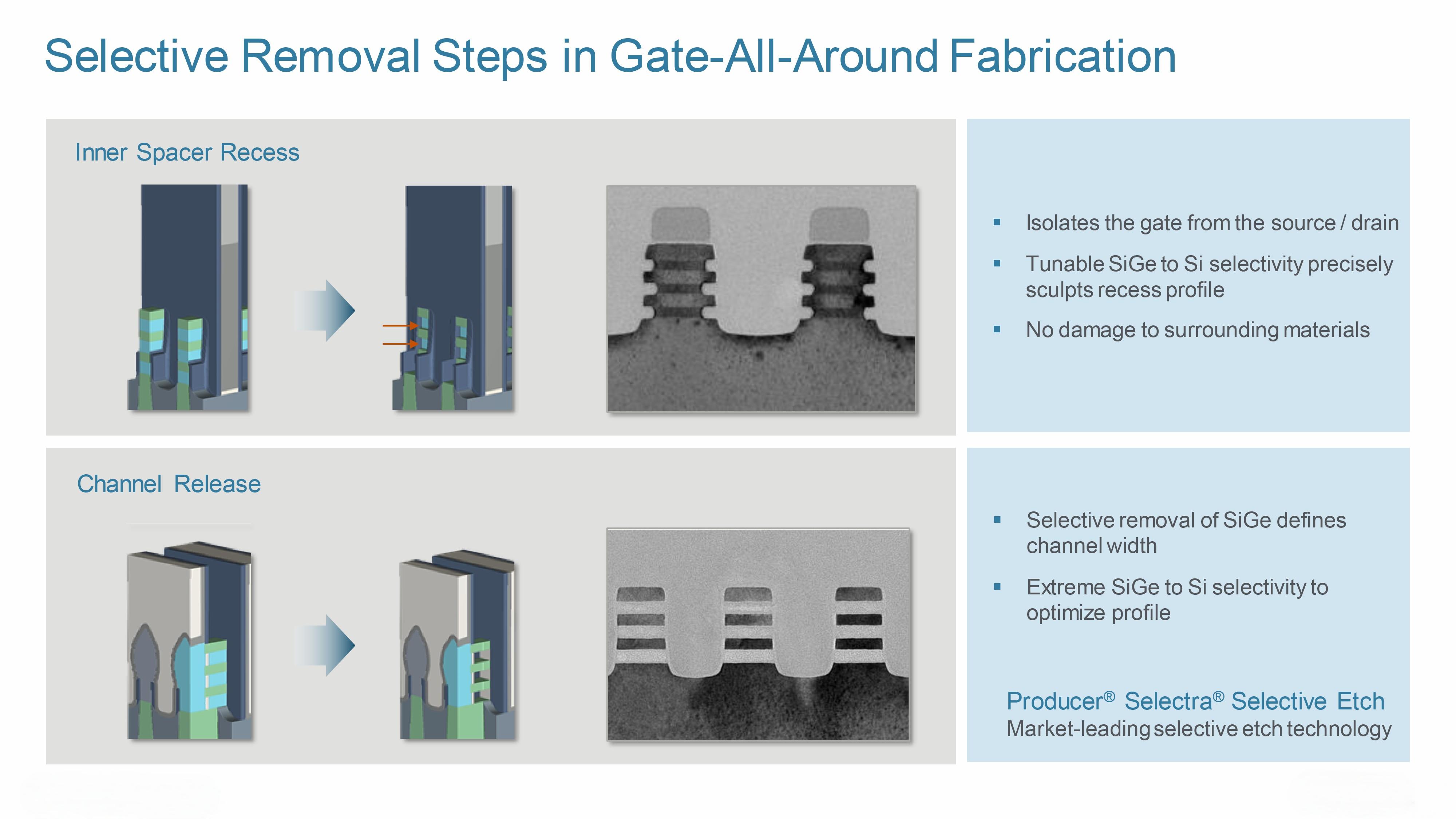
Ми в Semicorex спеціалізуємося наРозчини графіту з покриттям SiC/TaCзастосований у епітаксійному зростанні Si у виробництві напівпровідників, якщо у вас є запитання або вам потрібні додаткові відомості, будь ласка, не соромтеся зв’язатися з нами.
Контактний телефон: +86-13567891907
Електронна адреса: sales@semicorex.com




